
長(zhǎng)按識(shí)別二維碼關(guān)注公眾號(hào),點(diǎn)擊下方菜單欄左側(cè)“微信群”,申請(qǐng)加入群聊
1、SIP的基板材料要求
(1)低的介電常數(shù)、信號(hào)傳輸速度與基板材料的介電常數(shù)和信號(hào)傳輸距離有關(guān),介電常數(shù)越低,信號(hào)傳輸越快。
(2)低介電損耗。在基板材料的電導(dǎo)和松弛極化過(guò)程中,帶電質(zhì)點(diǎn)將電磁場(chǎng)能部分地轉(zhuǎn)化為熱能,將能量消耗在使封裝材料發(fā)熱的效應(yīng)上,介電損耗低能夠大大降低基板的發(fā)熱效應(yīng)。
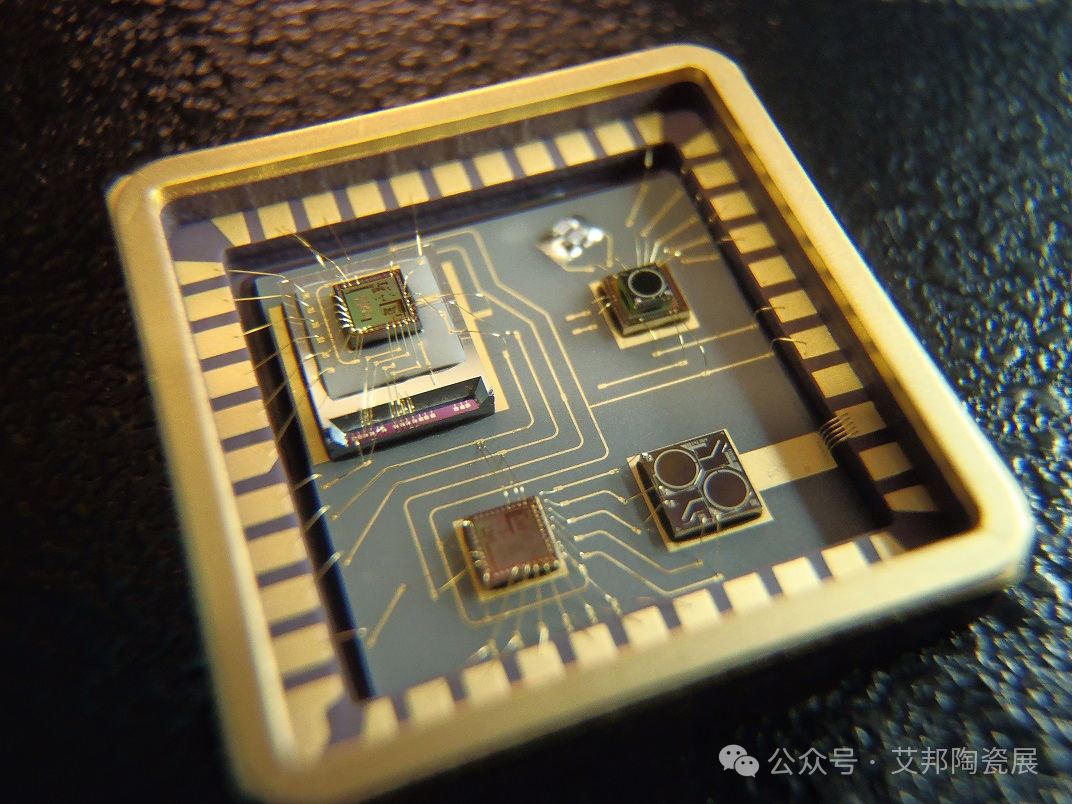
圖 系統(tǒng)級(jí)封裝,來(lái)源:ALTER
(3)高熱導(dǎo)率。芯片電路密度增加、功率提高信號(hào)速度加快、芯片發(fā)熱量增加,基板材料熱導(dǎo)率越高,能夠有效散發(fā)芯片發(fā)出熱量。
(4)適宜的熱膨脹系數(shù)。電路工作時(shí),由于熱膨脹系數(shù)不同會(huì)產(chǎn)生應(yīng)力,使焊點(diǎn)疲勞、失效,嚴(yán)重時(shí)導(dǎo)致膜層剝落,甚至破壞芯片,因此,基板材料要與芯片的熱膨脹系數(shù)匹配。
(5)良好的力學(xué)性能。基板材料需要具有良好的彎曲強(qiáng)度和彈性模量,一方面保證基板燒結(jié)過(guò)程中變形量小,減少尺寸差別;另一方面,保證基板在制備、裝配、使用過(guò)程中不至于破損。
二、SIP用陶瓷基板材料

1.AIN
SIP芯片堆疊后發(fā)熱量將增加,但散熱面積相對(duì)并未增加,因而發(fā)熱密度大幅提高,而且由于熱源的相互連接,熱耦合增強(qiáng),從而造成更為嚴(yán)重的熱問(wèn)題。同時(shí),內(nèi)埋置基板中的無(wú)源器件也有一定的發(fā)熱問(wèn)題。因此,SIP在封裝體積縮小、組裝密度增加的同時(shí)必然帶來(lái)散熱的問(wèn)題,選擇散熱效果更好即熱導(dǎo)率更高的陶瓷材料是實(shí)現(xiàn)SIP的關(guān)鍵。
AIN是一種具有纖鋅礦結(jié)構(gòu)的化合物,利用AIN陶瓷制成的多層陶瓷基板的熱導(dǎo)率可達(dá)170W/(m·K),熱膨脹系數(shù)僅為4.2x10-6°C-1,與Si、GaAs及GaN器件接近,其力學(xué)強(qiáng)度高,致密性好,能夠滿足封裝氣密性要求,且介電常數(shù)低,適用于高功率、多引線和大尺寸芯片,是SiP封裝優(yōu)選的基板材料和封裝材料。
2.低溫共燒陶瓷材料
LTCC(Low Temperature Co-fired Ceramic,低溫共燒陶瓷)采用厚膜材料,根據(jù)預(yù)先設(shè)計(jì)的結(jié)構(gòu),將電極材料、基板、電子器件等一次燒成,是實(shí)現(xiàn)SIP的重要途徑。LTCC工藝采用多層陶瓷疊壓燒結(jié),高頻介質(zhì)損耗小,高溫穩(wěn)定性好,膨脹系數(shù)與集成電路接近易匹配,容易與芯片集成,適合高低頻混合和數(shù)模一體化封裝。同時(shí),LTCC工藝又是一種三維無(wú)源基板,可以滿足系統(tǒng)高密度布線和緊湊復(fù)雜的無(wú)源電路要求,能充分發(fā)揮大規(guī)模集成電路的性能優(yōu)勢(shì)。采用LTCC技術(shù)的SIP具備高集成度,方便集成無(wú)源元件無(wú)源功能器件,通過(guò)調(diào)整配料和多種不同介電常數(shù)基板混合共燒的方式提高電路設(shè)計(jì)靈活性等。
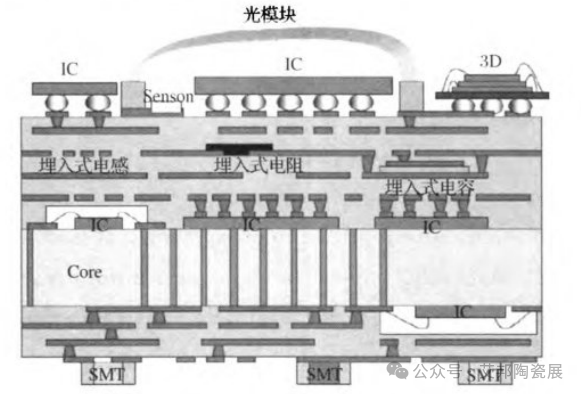
圖 系統(tǒng)級(jí)封裝橫截面示意圖
⑤基于LTCC技術(shù)的SIP同半導(dǎo)體器件有良好的熱匹配性能。LTCC的熱膨脹系數(shù)與Si、GaAs、InP接近,可以直接在基板上進(jìn)行芯片的組裝。
隨著封裝密度不斷提高、功能日趨多樣化,單一材料的性能已不能滿足需求。未來(lái)電子封裝材料將會(huì)朝著多相復(fù)合化的方向持續(xù)發(fā)展。
1.《系統(tǒng)級(jí)封裝用陶瓷基板材料研究進(jìn)展和發(fā)展趨勢(shì)》,高嶺,趙東亮.

河北·石家莊
序號(hào) | 暫定議題 | 擬邀請(qǐng) |
1 | 集成電路陶瓷封裝的發(fā)展概況 | 擬邀請(qǐng)?zhí)沾煞庋b廠商/高校研究所 |
2 | 光通信技術(shù)的發(fā)展及陶瓷封裝外殼的應(yīng)用趨勢(shì) | 擬邀請(qǐng)光通信企業(yè)/封裝廠商/高校研究所 |
3 | 電子封裝陶瓷的研究進(jìn)展 | 擬邀請(qǐng)?zhí)沾煞庋b廠商/高校研究所 |
4 | 陶瓷封裝技術(shù)在傳感器領(lǐng)域的應(yīng)用 | 擬邀請(qǐng)?zhí)沾煞庋b廠商/高校研究所 |
5 | 基于DPC的3D成型陶瓷封裝技術(shù) | 擬邀請(qǐng)?zhí)沾煞庋b廠商/高校研究所 |
6 | 集成電路陶瓷封裝外殼仿真設(shè)計(jì) | 擬邀請(qǐng)?zhí)沾煞庋b廠商/高校研究所 |
7 | 系統(tǒng)級(jí)封裝用陶瓷材料研究進(jìn)展和發(fā)展趨勢(shì) | 擬邀請(qǐng)?zhí)沾煞庋b廠商/高校研究所 |
8 | 基于3D-SiP集成技術(shù)的新型微波模塊 | 擬邀請(qǐng)?zhí)沾煞庋b廠商/高校研究所 |
9 | 陶瓷封裝結(jié)構(gòu)優(yōu)化及可靠性分析 | 擬邀請(qǐng)?zhí)沾煞庋b廠商/高校研究所 |
10 | 低溫玻璃-陶瓷封裝技術(shù)的研究進(jìn)展 | 擬邀請(qǐng)?zhí)沾煞庋b廠商/高校研究所 |
11 | 低溫共燒陶瓷基板及其封裝應(yīng)用 | 擬邀請(qǐng)?zhí)沾煞庋b廠商/高校研究所 |
12 | 微電子陶瓷封裝的金屬化技術(shù) | 擬邀請(qǐng)?zhí)沾煞庋b廠商/高校研究所 |
13 | 高溫共燒陶瓷金屬化膜厚影響因素分析 | 擬邀請(qǐng)?zhí)沾煞庋b廠商/高校研究所 |
14 | 銅漿在多層陶瓷封裝外殼制備技術(shù)中的應(yīng)用 | 擬邀請(qǐng)?zhí)沾煞庋b/漿料廠商/高校研究所 |
15 | 電子陶瓷封裝用玻璃粉的開(kāi)發(fā) | 擬邀請(qǐng)?zhí)沾煞庋b/玻璃粉廠商/高校研究所 |
16 | 金屬陶瓷膠黏劑封裝工藝及可靠性研究 | 擬邀請(qǐng)?zhí)沾煞庋b/材料廠商/高校研究所 |
17 | 陶瓷封裝外殼釬焊工藝研究 | 擬邀請(qǐng)釬焊設(shè)備企業(yè)/高校研究所 |
18 | 高密度陶瓷封裝外殼散熱問(wèn)題探討 | 擬邀請(qǐng)?zhí)沾煞庋b/材料廠商/高校研究所 |
19 | 陶瓷封裝平行縫焊工藝與技術(shù) | 擬邀請(qǐng)?zhí)沾煞庋b/設(shè)備廠商/高校研究所 |
20 | 陶瓷封裝缺陷自動(dòng)檢測(cè)技術(shù) | 擬邀請(qǐng)檢測(cè)方案商 |
方式一:加微信
李小姐:18124643204(同微信)
郵箱:lirongrong@aibang.com
掃碼添加微信,咨詢展會(huì)詳情


點(diǎn)擊閱讀原文,即可在線報(bào)名!
原文始發(fā)于微信公眾號(hào)(艾邦陶瓷展):一文了解系統(tǒng)級(jí)封裝SIP用陶瓷基板材料
長(zhǎng)按識(shí)別二維碼關(guān)注公眾號(hào),點(diǎn)擊下方菜單欄左側(cè)“微信群”,申請(qǐng)加入交流群。

